Dry etching 소개
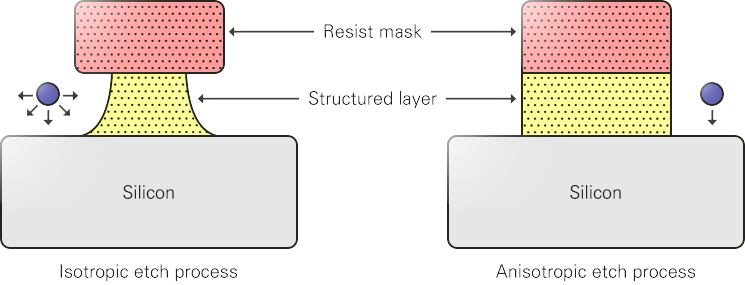
- 등방성 에칭 (Isotropic Etching)
- Radical과 막표면의 화학적인 반응만으로 박막 식각
- Radical의 random한 운동성으로 비등방성 etching 됨
- High selectivity (화학 반응성)
- 하부막 damage 적음
- undercut 발생, 미세 pattern 구현이 어려움
- 화학약품의 과다 사용으로 환경문제 대두
- 비등방성 에칭 (Anisotropic etching)
- Self-bias에 의해 가속된 Ion이 화학반응을 촉진시켜
etching 됨 - Ion이 한 방향으로 가속 되기 깨문에 측면 침식이 거의 없음
- 식각 resolution이 좋음 (1um 이하 가능)
- 물리적 충돌에 의한 식각도 일어나므로 하부막 damage에
주의 필요
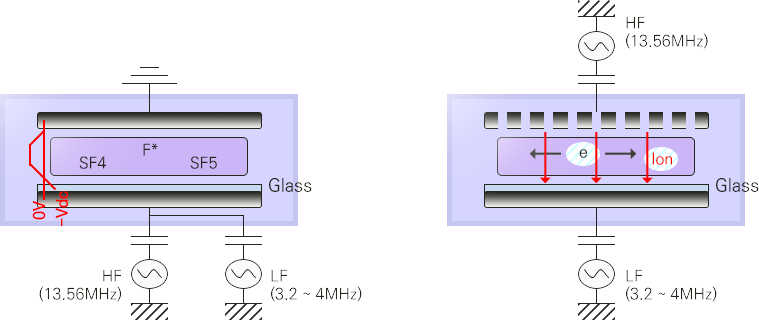
- ECCP
(Enhanced Capacitive Coupled Plasma) - 용량성 결합 플라즈마(CCP)는 평행평판 사이에 유전체가
끼어있는 형태를 가지는 플라즈마 발생 장치 - 플라즈마 밀도는 ICP 방식에 비해 높지 않지만 비교적
간단하게 대구경 플라즈마를 uniform하게 만들 수 있다는
장점이 있음 - 대면적에서 식각(etching), 박막 증착(deposition) 등이
가능하여 반도체 소자 및 박막형 Si계 태양전지 제조 공정에
널리 사용되는 장치
- ICP
(Inductive Coupled Plasma) - 유도결합형 플라즈마(ICP)의 간단한 원리는 반응 용기
(chamber)밖에 위치한 코일형태의 안테나에 전류를 흘려
안테나 주위에 유도전장에 의해 전자를 수평방행으로
진동시키고, 이때문에 전극에 흡수 되는 전자가 적어 다른
형태의 plasma source 보다 높은 전자 밀도를 가짐 - (고밀도 plasma 형성)하부 Bias 전극에서 Ion 을 끌어당겨
etching 을 진행함


